不久前,Exynos 几乎成了“过热、降频”的代名词;如今,局面正在被一项封装级散热变更改写。三星在 Exynos 2600 上引入的散热通道阻隔(HPB)技术,瞄准的不是简单的导热贴换大、腔体多开一个,而是把热路径重划:让热从处理器直达铜质散热片,同时把会“压在芯片头上的”DRAM移到侧面。这套思路已经带来显著收益——与上一代相比,芯片平均温度下降约30%。换句话说,频繁因热而退档的老毛病,有望在封装层面得到系统性缓解,而这场变革也不止服务于一颗Exynos。
HPB到底改了什么:铜片直触AP,DRAM“靠边站”
三星用于Exynos 2600处理器的散热通道阻隔(HPB)技术正引起广泛关注。 传统做法里,移动AP上方往往直接堆DRAM,高热密度区域上方“坐了个大盖子”,热量先被闷住,再绕行到上层或侧壁释放。HPB 反其道而行:在 AP 顶部封装铜基散热片,把DRAM移至芯片侧面,让高热先沿最短路径走;铜的高导热系数再把热迅速“抽走”。这种结构改变了以往“先被内存遮挡、再找路散热”的拥堵路径,使AP温度均值骤降,直接改善了降频触发的时机与幅度。
更关键的是,这不是“机身里多塞一片铜”的整机工程,而是封装层的结构创新。对终端厂来说,这意味着不改整机大框、也能拿到热行为改善;对SoC设计者来说,则是把散热做进芯片周边生态,减少对整机“堆料”的依赖。对于追求薄、轻、窄边的高端机型,这种“在封装里找面积”的散热尤为稀缺。
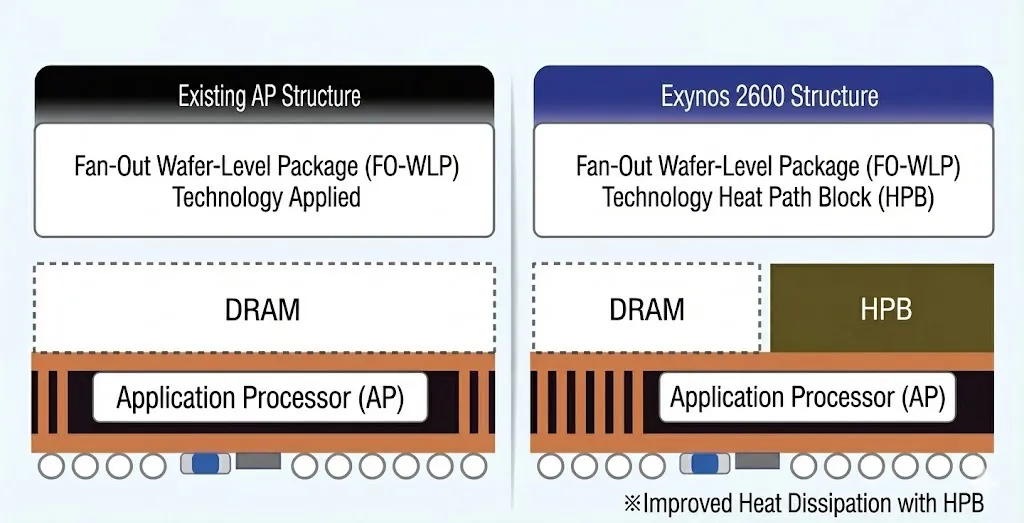
不止自救:ET News称三星拟将HPB外供,高通与苹果在列
据韩国ET News报道,三星计划把 HPB 封装技术向其他客户开放,其中包括高通与苹果。这听起来微妙:苹果早在2016年就把 A10 的封装工艺切到了台积电;高通也在 2022年将 骁龙8 Gen 1+ 的封装转向台积电。但封装供应链并非只能“一条龙到底”,在特定模组与封装子方案层面,跨供应商协作并不罕见——尤其当一项技术能带来确定性的热收益时。
把背景再拉近一点:骁龙8 Elite Gen 5 近期在相同基准测试场景下,曝出约19.5W的功耗数据;与之对照,A19 Pro 约 12.1W。在绝对散热预算受限的手机形态里,发热峰值与热扩散路径之间的矛盾越来越尖锐。与此同时,Exynos 2600 虽未公布最终CPU簇配置,但一份来自可靠渠道的内部跑分称其主核心时钟频率仅比骁龙8 Elite Gen 5的性能核高4.6%——频点不盲目“上头”的同时,再配上HPB 这类降低热阻的封装能力,稳定性能曲线的空间被打开了。
从需求端看,高通正急需在下一代AP上抑制峰值热密度;从供给端看,苹果对封装级散热的兴趣一向浓厚(A系列每代都在封装、底层互连、芯片堆叠上做文章)。HPB 的落点恰好卡在两者的共需:不改整机架构、不牺牲厚度的前提下,为AP释放更稳定的功耗-温度曲线。
HPB像是一条“行业公路”,先帮Exynos止损,也给骁龙与A系留后路
如果把“发热—降频”看作手机里最难啃的骨头之一,那么HPB 给出的不是“换锅”的治标逻辑,而是改炉灶的治本办法:把热路径从封装级重新规划。它让 Exynos 2600 的平均温度下降约30%,把“被内存捂着”的顽疾打散;它也给高负载AP一个现实的优化通道,尤其当骁龙8 Elite Gen 5 这类“性能核凶猛”的芯片,已经把功耗拉到19.5W这个级别,而对面 A19 Pro 还能把同场景压在12.1W。
从更大的产业视角看,封装级散热将成为旗舰AP的标配博弈点。制程带来的PPA红利在放缓,简单拉频、盲目放大缓存或堆更多大核,都会在手机这样的窄腔体里迅速遭遇热墙。把DRAM移侧、让铜片直触AP这种“通道级改造”,正好补上芯片热设计的结构性短板。
所以,当ET News爆出三星有意外供HPB,并点名苹果与高通时,这更像是一条面向行业的“散热公路”:先帮自家 Exynos 把“发热锅”放下,再把路铺给潜在的A系与骁龙。考虑到Exynos 2600主核频点仅比骁龙性能核高约4.6%的保守策略,结合HPB,稳定输出或许比极限峰值更值得期待——而这,正是用户真正体感到的“快”。
